Impurezas em camadas epitaxiais
:: Referências :: Outros projetos
As dopagens p e n têm sido estudadas em camadas epitaxiais de InAlAs. Os dopantes p são o Zn e o C, este último tem como fonte o tetrabrometo de carbono. O dopante n é o Si. O estudo da dopagem p está em andamento e os resulatdos obtidos são preliminares.
No caso da dopagem n, observamos que tanto a concentração líquida de carga como a concentração de portadores livres dependem linearmente do fluxo de Si durante o crescimento. Na realidade, os dados obtidos com efeito Hall e CV coincidem.Isso indica uma ausência de níveis profundos. Nenhum sinal de saturação foi observado até uma concentração de cerca de 5 x 1018 cm-3. Porém, estudos feitos com fotoluminescência em amostras ditas as-grown e recozidas a 800ºC por uma hora numa atmosfera inerte mostram a presença de uma emissão em torno de 41 eV abaixo do gap, atribuída à transição banda de condução – aceitador SiAs. Essa emissão cresce com o fluxo de silana e com o tratamento térmico. O tratamento térmico induz a produção de vacâncias de As que podem então ser substituídas por átomos de Si. Medidas de concentração líquida de carga após o tratamento térmico mostram uma diminuição na concentração de portadores. Conclui-se que um efeito de autocompensação está sempre presente e pode ser detectado opticamente. Além disso, cálculos da energia de ionização do aceitador usando um modelo tight-binding, forneceram um valor de cerca de 60 meV. Levando em consideração a incerteza na determinação da massa efetiva dos buracos em InAs, esse valor é considerado bastante próximo do valor determinado experimentalmente.

Fig. 1 Dependência da densidade de portadores livres (n) e densidade de carga líquida (N) com a pressão parcial de entrada de silana normalizada. n foi medida por efeito Hall (quadrados) e N por CV (círculos vazios). A mobilidade também está incluída (círculos cheios).
A dopagem p em camadas de InAlAs, onde o dopante é o C, foi estudada em função da temperatura de crescimento. Observamos que a temperaturas de crescimento inferiores a 620°C a amostra é tipo p e que para temperaturas mais elevadas o material é tipo n. Esse efeito está relacionado com a anfotericidade do C, presença de átomos de H que passivam o dopante e a incorporação de níveis profundos. A concentração de tais níveis profundos está diretamente correlacionada com a concentração atômica de C.
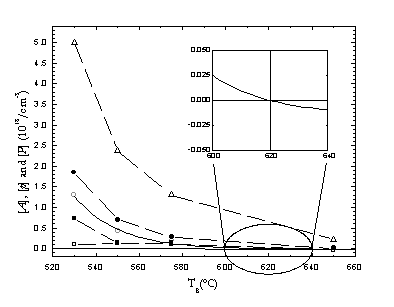
Fig. 2 Concentração atômica, de portadores livres e de carga líquida em função da temperatura de crescimento. Observa-seuma transição de material tipo p para tipo n em torno de 620°C.
A dopagem de C também foi estudada em AlGaAs em função da razão III/V. Variando esse parâmetro a dopagem passa de intrínseca à dopagem residual.Encontramos condições ideais de crescimento para se obter controle sobre o nível de dopagem. Uma localização dos átomos de C em uma região inferior a 8 Å foi obtida nas camadas de AlGaAs com dopagem planar.

Fig. 3 Concentração de carga líquida em função do fluxo de CBr 4 para diferentes valores da razão III/V.
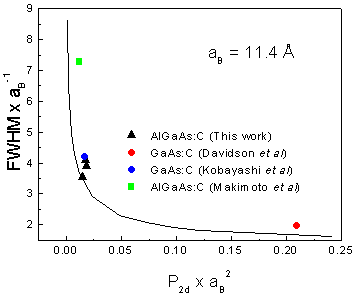
Fig. 4 Largura a meia altura da distribuição de carga em função da dopagem superficial. A curva sólida mostra um cálculo assumindo que as impurezas estão localizadas numa região de 8 Å de espessura, equivalente a 70 % do raio de Bohr, aB.
Os resultados obtidos se encontram disponíveis nas seguintes referências:
Effect of growth temperature on C-doped InAlAs layers grown by LP-MOVPE
M. L. Ribeiro, P. L. Souza, C. V. B.-Tribuzy e B.Yavich
Journal of Crystal Growth 248, 134 a 138, 2003.
Carbon doping in InAlAs grown by MOVPE
M. L. P. Ribeiro, C. V.-B. Tribuzy, B. Yavich e P. L. Souza
Brazilian Journal of Physics 32, 362 a 365, 2002.
Carbon delta-doped AlGaAs
Christiana V.-B. Tribuzy, Rainer Butendeich, Maurício P. Pires, Patrícia L. Souza e André Henriques
Journal of Applied Physics 90, 1660, 2001.
Si incorporation in InAlAs grown by LP-MOVPE assessed by optical and transport measurements
C. V.-B Tribuzy, P. L. Souza, B. Yavich e J. Menchero
Journal of Vacuum Science and Technology B 18, 74, 2000
Study of Si incroporation in InAlAs by optical and transport techniques
C. V.-B Tribuzy, P. L. Souza e B. Yavich
Apresentação no 9th Brazilian Workshop on Semiconductor Physics, Belo Horizonte, MG, Brasil, fevereiro de 1999.
Si incorporation in InAlAs grown by LP-MOVPE assessed by optical and transport techniques
C. V.-B Tribuzy, P. L. Souza e B. Yavich
Proceedings da 24th International Conference on the Physics of Semiconductors, Jerusalem, Israel, World Scientific (1998).
